一. 消息面汇总
AI浪潮下,先进封装需求水涨船高,CoWoS之外,另一先进封装技术也走向聚光灯下。
目前台积电正大举扩产SoIC(系统级集成单芯片)产能,正向设备厂积极追单。
台积电激进扩产SoIC或与大客户需求有关:AMD是台积电SoIC的首发客户,其最新AI芯片产品正处于量产阶段,预计明年上市的MI300芯片将采用SoIC搭配CoWoS。
苹果则将采用SoIC搭配热塑碳纤板复合成型技术,目前正小量试产,预计2025-2026年量产,拟应用在Mac、iPad等产品。
台积电另一大客户英伟达,其目前产品主要采用CoWoS封装技术。

二. SoIC封装技术解析
作为台积电先进封装技术组合3D Fabric的一部分,台积电SoIC是业内第一个高密度3D chiplet堆叠技术。
SoIC设计是在创造键合界面,让芯片可以直接堆叠在芯片上。
封装技术主要指标为凸点间距,凸点间距越小,封装集成度越高,难度越大。台积电的3D SoIC的凸点间距最小可达6um,居于所有封装技术首位。
与CoWoS技术相比,SoIC可提供更高的封装密度、更小的键合间隔,还可以与CoWoS/InFo共用,实现多个小芯片集成。
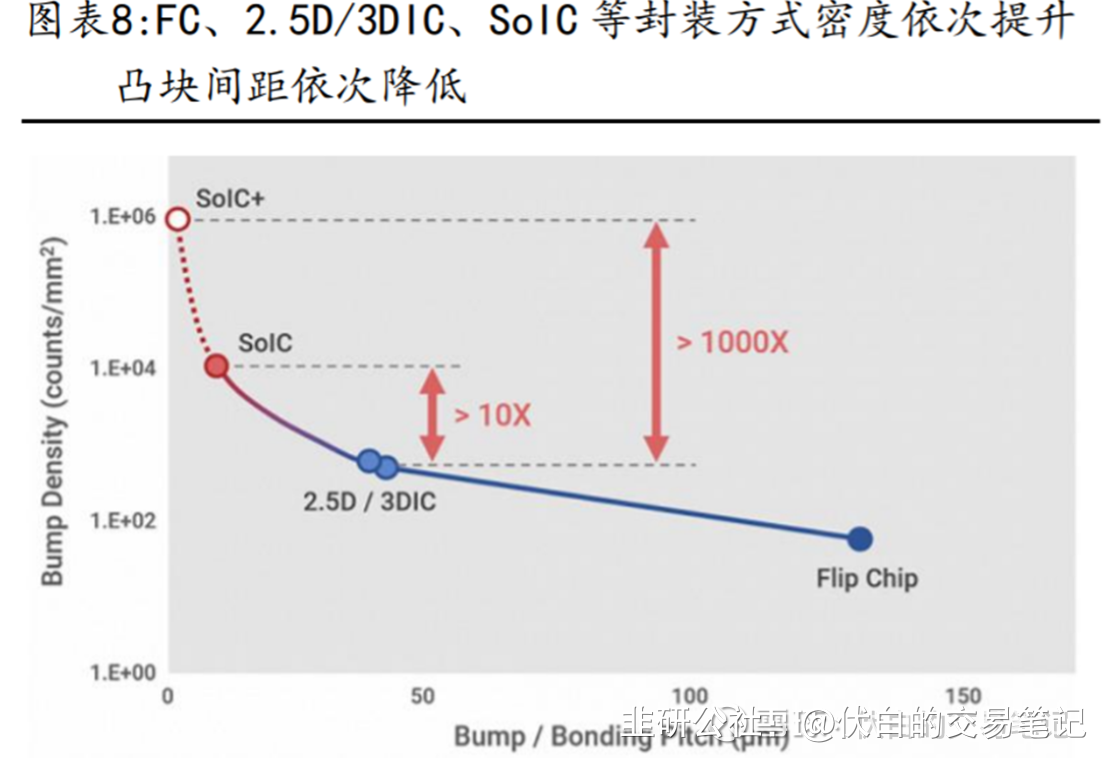
三. 相关个股梳理
先进封装设备投资额约占产线总投资的87%。
相较传统封装,先进封装对测试机的需求量增多;同时因为多了凸点制造、RDL、TSV等工艺,产生包括光刻设备、刻蚀设备、电镀设备、薄膜沉积设备等在内的新需求。
(1)封测厂商
国内厂商包括:长电科技、 通富微电、华天科技、晶方科技。
(2)先进封装材料
国内厂商包括:兴森科技、华海诚科、联瑞新材、宏昌电子、飞凯材料、壹石通、德邦科技、华正新材。
兴森科技:主营PCB印制电路板、半导体测试板、IC封装基板。公司FCBGA封装基板应用于GPU、FPGA、高端ASIC、AI芯片等高端芯片封装。
华海诚科:半导体封装材料供应商,公司成功研发了应用于QFN/BGA、FC、SiP、FOWLP/FOPLP等封装形式的封装材料。
联瑞新材:无机填料和颗粒载体行业产品供应商,公司有产品批量用于半导体先进封装材料。
(3)封测设备
国内厂商包括:至正股份、易天股份、长川科技、文一科技、光力科技、芯碁微装。
文一科技:半导体封测专业设备供应商,公司正在研发的晶圆级封装设备,可用于第三代半导体材料封装。
光力科技:主营半导体封装测试环节的精密加工设备,包括划片、切割系列设备。公司的高端切割划片设备可用于Chiplet等先进封装中的切割工艺。



- 1








