尽管Nvidia试图大幅增加产量,最高端的Nvidia GPU H100将一直售罄到明年第一季度。这种现状短期没法改变,真正的瓶颈是CoWoS容量,或者更准确的说是先进封装技术。
从历史沿革看,微电子技术大致遵循着“摩尔定律”快速发展。但近年来,随着芯片制程工艺的演进,“摩尔定律”迭代进度放缓,导致芯片的性能增长边际成本急剧上升。据IBS统计,在达到 28nm制程节点以后,如果继续缩小制程节点,每百万门晶体管的制造成本不降反升。

而另一方面,在摩尔定律减速的同时,计算需求却在暴涨。随着云计算、大数据、人工智能、自动驾驶等新兴领域的快速发展,对算力芯片的效能要求越来越高。
后摩尔时代,在计算需求瓶颈、芯片制造面临物理极限与经济效益边际提升多重挑战下,半导体行业开始探索新的发展路径。
其中,先进封装成为超越摩尔定律方向中的一条重要赛道。
先进封装在提高芯片集成度、缩短芯片距离、加快芯片间电气连接速度以及性能优化的过程中扮演了更重要角色,正成为助力系统性能持续提升的重要保障,并满足“轻、薄、短、小”和系统集成化的需求。
可见,随着大算力需求提升,以及单芯片向更先进制程推进难度的增大,先进封装替代先进制程成为降低单位算力成本的关键方案。
Yole Group最新的Advanced Packaging Market Monitor数据显示 ,全球先进封装市场规模将由2022年的443亿美元,增长到2028年的786亿美元,年复合成长率(CAGR)为10.6%。

从晶圆代工厂商动态来看,在代工制程按照摩尔定律飞速发展的甜蜜期,封装并没有进入晶圆代工厂的视野。然而,近几年来随着摩尔定律失速,先进制程的成本快速提升,一些晶圆代工大厂的发展重心正在从过去追求更先进纳米制程,转向封装技术的创新。诸如台积电、英特尔、三星、联电等芯片制造厂商纷纷跨足封装领域,先进封装技术无疑成为代工巨头角逐的重要战场。
台积电优势凸显
早在10多年前台积电就看出随着半导体前段工艺的快速微缩,后段封装技术会跟不上前段工艺的脚步,等到那时,摩尔定律真的会失效。因此毅然决定投入封装技术,在2008年底成立了导线与封装技术整合部门(IIPD )。
目前台积电最爆款的封装技术是CoWos技术。CoWoS是台积电的一种“2.5D”封装技术,其中多个有源硅芯片(通常的配置是逻辑和HBM堆栈)集成在无源硅中介层上。中介层充当顶部有源芯片的通信层。然后将内插器和有源硅连接到包含要放置在系统PCB上的I/O的封装基板。目前绝大多数CoWoS需求来自人工智能。与半导体供应链的其他部分不同,其他主要终端市场的疲软意味着有足够的闲置空间来吸收GPU需求的巨大增长,CoWoS和HBM已经是大多数面向人工智能的技术,因此所有闲置空间已在第一季度被吸收。随着GPU需求的爆炸式增长,供应链中的这些部分无法跟上并成为GPU供应的瓶颈。

除了CoWoS,台积电还有其他封装技术。2018年4月的美国加州圣塔克拉拉第二十四届年度技术研讨会上,台积电首度对外界公布了创新的系统整合单芯片(SoIC)多芯片3D堆叠技术。
据介绍,SoIC是一种创新的多芯片堆叠技术,是一种晶圆对晶圆的键合技术,SoIC是基于台积电的CoWoS与多晶圆堆叠(WoW)封装技术开发的新一代创新封装技术,这标志着台积电已具备直接为客户生产3D IC的能力。相较2.5D封装方案,SoIC的凸块密度更高,传输速度更快,功耗更低。
2020年,台积电宣布将其2.5D和3D封装产品合并为一个全面的品牌3DFabric,进一步将制程工艺和封装技术深度整合,以加强竞争力。3DFabric平台由SoIC(系统整合芯片)、InFO(整合型扇出封装技术)、CoWoS(基板上芯片封装)所组成,提供业界最完整且最多用途的解决方案,用于整合逻辑小芯片技术(Chiplet)、HBM、特殊制程芯片,实现更多创新产品设计。

英特尔紧追不舍,三星略显迟缓
2018年12月,英特尔展示了名为“Foveros”的全新3D封装技术,这是继2018年英特尔推出突破性的EMIB封装技术之后,英特尔在先进封装技术上的又一个飞跃。今年5月,英特尔发布了先进封装技术蓝图,计划将传统基板转为更为先进的玻璃材质基板。
而随着英特尔提出IDM 2.0发展策略,晶圆代工业务成为英特尔重要转型项目,除了为高通等无厂半导体企业代工制造以外,其封装技术也是英特尔极力推销的对象。英特尔表示,客户可选择由台积电、GF等进行代工,之后利用英特尔技术进行封装、测试,这一模式将为客户带来更灵活的产品制造方式。英特尔强调,目前已经与全球前10大芯片封装厂旗下客户进行洽谈,并且获得Cisco、AWS在内业者青睐。
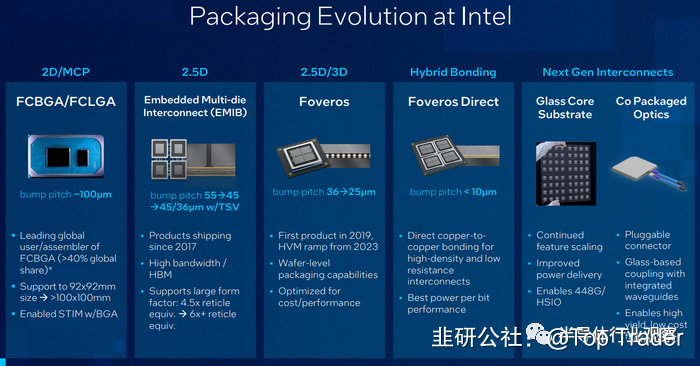
另一方面,今年6月,三星宣布与内存、基板封装、测试等领域的合作伙伴成立“MDI(多芯片集成)联盟”,构建2.5D和3D异构集成的封装技术生态在此之前,三星已经推出了I-Cube、X-Cube等2.5D和3D封装技术,此次成立联盟将提升其产业链整合能力,以及一站式和定制化服务能力。
针对2.5D封装,三星推出的I-Cube封装制程可与台积电CoWoS封装制程相抗衡;3D IC技术方面,三星2020年推出X-Cube封装,将硅晶圆或芯片物理堆叠在一起,每个晶圆都通过硅通孔(TSV)连接,最大程度上缩短互连长度,在降低功耗的同时能提高传输速率。

随着运算需求的日益复杂,异构计算大行其道,更多不同类型的芯片需要被集成在一起,而依靠缩小线宽的办法已经无法同时满足性能、功耗、面积以及信号传输速度等多方面的要求。
在此情况下,越来越多的半导体厂商开始把注意力放在系统集成层面。除了传统委外封测厂商(OSAT)之外,近年来晶圆代工厂、IDM也在大力发展先进封装或相关技术,甚至有Fabless和OEM也参与其中,通过封装技术寻求解决方案。
Foundry方面,由于2.5D/3D封装技术中涉及前道工序的延续,晶圆代工厂对前道制程非常了解,对整体布线的架构有更深刻的理解,走的是芯片制造+封装高度融合的路线。
因此,在高密度的先进封装方面,Foundry比传统OSAT厂更具优势。这也使得先进封装成为当前业内几大主流半导体晶圆制造厂商重点发展的技术。台积电、英特尔和三星等代工巨头已成功利用先进封装市场的增长,实现了其技术壁垒的不断提升。而随着国际几大巨头开始发力先进封装,国内的封装产业也是生机勃勃,各大公司争相角逐这个赛道,相关产业链公司将迎来长坡厚雪的市场机遇。
甬矽电子688362
甬矽电子专注于中高端先进封装和测试业务,报告期内公司全部产品均为中高端先进封装形式,包括 FC 类产品、 SiP 类产品、BGA 类产品等,属于国家重点支持的领域之一。

公司在SiP领域具备丰富的技术积累,同时通过实施晶圆凸点产业化项目布局“扇入型封装”(F an-in)、“扇出型封装”(F an-out)、2.5D、3D等晶圆级和系统级封装应用领域,并为进一步拓展异构封装领域打下基础。
另一方面,FC类产品中除现有产品外,公司持续完善公司自身产品线布局,积极推进FCBG等产线的实施,努力打造成为最具竞争力的一站式Turnkey封测基地。

颀中科技688352
公司的主要从事集成电路的先进封装与测试业务,目前主要聚焦于显示驱动芯片封测领域和以电源管理芯片,射频前端芯片为代表的非显示类芯片封测领域。公司也是全国唯一一家能够提供DDIC全制程段封测服务的企业。
颀中科技能够为客户提供全方位一站式先进封测的解决方案,包含凸块加工、晶圆测试、研磨切割、封装测试等制程服务,以及光罩设计、COF卷带图面设计、测试程式开发、探针卡设计及维修等配套服务。公司为显示驱动芯片提供COF/COG/COP封装方案,具备行业领先的全方位的显示封装技术,可以为客户提供12um超细间距Super Fine Pitch COF、双面铜2-Metal COF、多芯片Multi-Chip COF、125mm大版面COF及多种散热解决方案。

联瑞新材688300
公司持续聚焦面向先进封装材料以及面向5G高频高速覆铜板应用需求的球形陶瓷粉体材料的研发。先进芯片封装用电子级亚微米球形硅微粉、底部填充胶用化学合成球形二氧化硅微粉、高可靠车载板用低杂质硅微粉等项目已经结题并实现产业化。
2021年8月15日,联瑞新材发布公告称,为了持续满足新一代芯片封装、高频高速电路基板等领域的客户需求,不断完善球形硅基和铝基产品的产能布局,进一步扩大球形粉体材料产能,拟投资3亿元实施年产15000吨高端芯片封装用球形粉体生产线建设项目。目前该项目已于2022年四季度顺利调试,2023年上半年已向市场投放一半产能,公司对下半年需求预期持乐观态度。

德邦科技688035
公司集成电路封装材料部分产品可应用于2.5D和3D等先进封装互连技术。其中DAF、CDAF相关产品可应用在集成电路芯片的多维封装、叠加封装等高端封装工艺中,竞争对手以国际封装材料企业为主,国内未看到其他友商能够生产。

此前财通证券发布研报,给予德邦科技增持评级。评级理由主要包括:①先进封装技术带动公司相关集成电路封装材料需求高增;② AI技术的应用将带动智能终端需求的提升,受益公司相关智能终端材料
同兴达002845
2022年,深圳同兴达与千灯镇及日月新集团达成合作,建设同兴达半导体先进封装项目。该项目预计总投资30亿元,一期总投资9.8亿元,达产后产值预计32亿元纳税1.7亿元。双方将共建"芯片先进封测(Gold Bump)全流程封装测试"生产线,由昆山同兴达投资 Gold Bumping(金凸块)段所需设备、晶圆测试段测试机、COF/COG 段所需专用设备至生产线所在地,产能配置 2万片/月。

2023年2月1日,同兴达半导体先进封装项目首台”SMEE光刻机”正式搬入昆山厂房。




- 1
- 2















